基于电晕的非接触CV法测定碳化硅的载流子

碳化硅系列第35篇
如果感觉文章很长
那是我们要走很远
在载流子一文中,我们提到了使用汞探针法测试碳化硅的载流子浓度、掺杂浓度、电阻率等。通过控制电压大小,观察电容变化,从而推测其中载流子的情况,这就是CV法的核心。
今天,将介绍基于电晕的非接触CV法(corona-based non-contact CV, 简称Cn-CV),不通过金属来导电传递电压,而是通过空气的电晕放电提供电压,之后同样观察电容变化,从而推测其中载流子的情况。
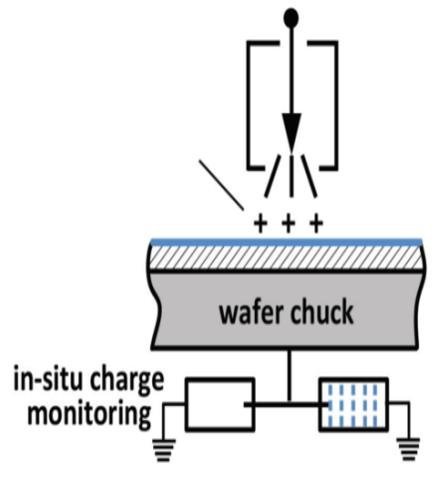
实验表明,Cn-CV法与汞探针CV法的测量结果一致。那么,Cn-CV法的非接触式测量,就具有很大的优势了,不但不破坏表面、还不会污染表面。
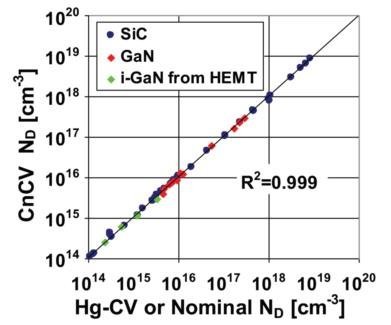
Cn-CV法还有一个独特的优点,因为没有探针遮挡,因此可以外加光源。采用一系列由LED激发过量载流子产生的光致表面电压脉冲,直接测定平带电压和C-Q特性曲线。使用这种方法,无须了解半导体或介电特性,或者不需要对界面状态水平进行假设就可以确定平带电压。
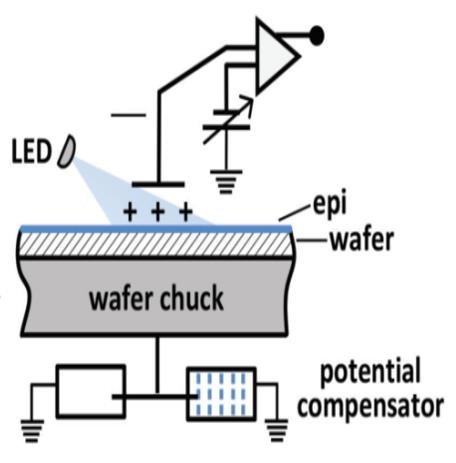
对于标准的MOS C-V技术则不是这样,它在确定平带电压的时候要假定界面状态贡献可以忽略。比如下图所示,可以得到的45mm厚n型SiC绝缘层的V-Q和C-Q特性曲线,以及光照引起界面陷阱的光电离和C-Q特性曲线的负偏移。

参考文献
非接触电计量:削减成本和缩短时间
To Be Continue
- 助你建立碳化硅全息地图 -
