光刻胶由光引发剂、树脂、溶剂等基础组分组成,又被称为光致抗蚀剂,这是一种对光非常敏感的化合物。此外,光刻胶中还会添加光增感剂、光致产酸剂等成分来达到提高光引发效率、优化线路图形精密度的目的。在受到紫外光曝光后,它在显影液中的溶解度会发生变化。
分类
根据光刻胶按照如何响应紫外光的特性可以分为两类。
正胶(Positive Photo Resist)
曝光前对显影液不可溶,而曝光后变成了可溶的,能得到与掩模板遮光区相同的图形。
优点:分辨率高、对比度好。
缺点:粘附性差、抗刻蚀能力差、高成本。
灵敏度:曝光区域光刻胶完全溶解时所需的能量
负胶(Negative Photo Resist)
与正胶反之。
优点: 良好的粘附能力和抗刻蚀能力、感光速度快。
缺点: 显影时发生变形和膨胀,导致其分辨率。
灵敏度:保留曝光区域光刻胶原始厚度的50%所需的能量。

按感光树脂的化学结构,光刻胶可分为光聚合型光刻胶、光分解型光刻胶和光交联型光刻胶。在应用中,采用不同单体可以形成正、负图案,并可在光刻过程中改变材料溶解性、抗蚀性等。
光聚合型光刻胶
烯类,在光作用下生成自由基,自由基再进一步引发单体聚合。
光分解型光刻胶
叠氮醌类化合物,经光照后,会发生光分解反应,由油溶性变为水溶性。
光交联型光刻胶
聚乙烯醇月桂酸酯,在光的作用下,分子中的双键打开,链与链之间发生交联,形成一种不溶性的网状结构从而起到抗蚀作用。
按曝光波长,光刻胶可分为紫外(300~450 nm)光刻胶、深紫外(160~280 nm)光刻胶、极紫外(EUV,13.5 nm)光刻胶、电子束光刻胶、离子束光刻胶、X 射线光刻胶等。
按应用领域,光刻胶可分为PCB 光刻胶、LCD 光刻胶、半导体光刻胶等。PCB 光刻胶技术壁垒相对其他两类较低,而半导体光刻胶代表着光刻胶技术最先进的水平。
PCB 光刻胶
主要分为干膜光刻胶、湿膜光刻胶(又称为抗蚀刻/线路油墨)、光成像阻焊油墨等。PCB 光刻胶技术壁垒相对较低,主要是中低端产品。
LCD 光刻胶
包含彩色滤光片用彩色光刻胶及黑色光刻胶、LCD 触摸屏用光刻胶、TFT-LCD 正性光刻胶等产品。
彩色滤光片是LCD 实现彩色显示的关键器件,占面板成本的14%~16%;在彩色滤光片中,彩色光刻胶和黑色光刻胶是核心材料,占其成本的27%左右,其中黑色光刻胶占彩色滤光片材料成本的6%~8%。
半导体光刻胶
包括g 线光刻胶、i 线光刻胶、KrF 光刻胶、ArF 光刻胶、聚酰亚胺光刻胶、掩膜板光刻胶等。
光刻胶组分及功能
光引发剂
光引发剂吸收光能(辐射能)后经激发生成活性中间体,并进一步引发聚合反应或其他化学反应,是光刻胶的关键组分,对光刻胶的感光度、分辨率等起决定性作用。
树脂
光刻胶的基本骨架,是其中占比最大的组分,主要决定曝光后光刻胶的基本性能,包括硬度、柔韧性、附着力、曝光前后对溶剂溶解度的变化程度、光学性能、耐老化性、耐蚀刻性、热稳定性等。
溶剂
溶解各组分,是后续聚合反应的介质,另外可调节成膜。
单体
含有可聚合官能团的小分子,也称之为活性稀释剂,一般参加光固化反应,可降低光固化体系粘度并调节光固化材料的各种性能。
光增感剂
是引发助剂,能吸收光能并转移给光引发剂,或本身不吸收光能但协同参与光化学反应,起到提高引发效率的作用。
光致产酸剂
吸收光能生成酸性物质并使曝光区域发生酸解反应,用于化学增幅型光刻胶。
助剂
根据不同的用途添加的颜料、固化剂、分散剂等调节性能的添加剂。
主要技术参数
分辨率(resolution)
是指光刻胶可再现图形的最小尺寸。一般用关键尺寸来(CD,CriticalDimension)衡量分辨率。
对比度(Contrast)
指光刻胶从曝光区到非曝光区过渡的陡度。
敏感度(Sensitivity)
光刻胶上产生一个良好的图形所需一定波长光的最小能量值(或最小曝光量)。单位:毫焦/平方厘mJ/cm2。
粘滞性/黏度 (Viscosity)
衡量光刻胶流动特性的参数。光刻胶中的溶剂挥发会使粘滞性增加。
粘附性(Adherence)
是指光刻胶与晶圆之间的粘着强度。
抗蚀性(Anti-etching)
光刻胶黏膜必须保持它的粘附性,并在后续的湿刻和干刻中保护衬体表面,这种性质被称为抗蚀性。
表面张力(SurfaceTension)
液体中将表面分子拉向液体主体内的分子间的吸引力。
光刻工艺流程
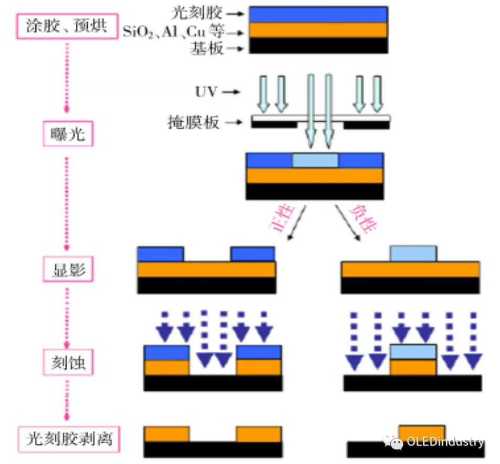
1
前处理
微粒清除:
wafer表面的杂质微粒会影响光刻胶的粘附,且会损坏光刻的图形,造成成品率的下降,所以必须要清洁掉表面的杂质颗粒、表面沾污以及自然氧化层等。
微粒清除方法:
高压氮气吹除,化学湿法清洗,旋转刷刷洗,高压水喷溅等。
烘干:
经过清洁处理后的晶圆表面会含有一定的水分(亲水性表面),所以必须将其表面烘烤干燥(干燥的表面为憎水性表面),以便增加光刻胶和晶圆表面的粘附能力。
保持憎水性表面的方法:
一种是把室内湿度保持在50%以下,并且在晶园完成前一步工艺之后尽可能快地对晶园进行涂胶。另一种是把晶园储存在用干燥且干净的氮气净化过的干燥器中。
此外,一个加热的操作也可以使晶圆表面恢复到憎水性表面。
有三种温度范围:150℃-200℃(低温),此时晶圆表面会被蒸发;到了400℃(中温)时,与晶圆表面结合较松的水分子会离开;当超过750℃(高温)时,晶圆表面从化学性质上将恢复到了憎水性条件。通常采用低温烘烤,原因是操作简单。
增粘处理:
增粘的作用是增强wafer与光刻胶之间的粘着力。
原因是绝大多数光刻胶所含的高分子聚合物是疏水的,而氧化物表面的羟基是亲水的,两者表面粘附性不好。
通常用的增粘剂:
HMDS(六甲基二硅胺烷)。亲水的带羟基的硅烷醇→疏水的硅氧烷结构,既易与晶圆表面结合,又易与光刻胶粘合。
方法有:
沉浸式,旋涂法和蒸汽法
2
涂胶
涂胶工艺的目的就是在晶园表面建立薄的、均匀的、并且没有缺陷的光刻胶膜。一般来说,光刻胶膜厚从0.5um到1.5um不等,而且它的均匀性必须达到只有正负0.01um的误差。
光刻胶的涂覆常用方法是旋转涂胶法:
静态旋转和动态喷洒
静态涂胶:
首先把光刻胶通过管道堆积在晶圆的中心,然后低速旋转使光刻胶铺开,再高速旋转甩掉多余的光刻胶,高速旋转时光刻胶中的溶剂会挥发一部分。

静态涂胶时的堆积量非常关键,量少了会导致负胶不均匀,量大了会导致晶圆边缘光刻胶的堆积甚至流到背面。

动态喷洒:
随着wafer直径越来越大,静态涂胶已不能满足要求,动态喷洒是以低速旋转,目的是帮助光刻胶最初的扩散,用这种方法可以用较少量的光刻胶而达到更均匀的光刻胶膜,然后高速旋转完成最终要求薄而均匀的光刻胶膜。

涂胶的质量要求是:
(1)膜厚符合设计的要求,同时膜厚要均匀,胶面上看不到干涉花纹;
(2)胶层内无点缺陷(如针孔等);
(3)涂层表面无尘埃和碎屑等颗粒。
膜厚的大小可由下式决定:

式中,T为膜厚;P为光刻胶中固体的百分比含量;S为涂布机的转速;K为常数。
3
软烘烤
主要目的有:使胶膜内的溶剂挥发,增加光刻胶与衬底间的粘附性、光吸收以及抗腐蚀能力;缓和涂胶过程中胶膜内产生的应力等。
4
对准和曝光
对准是把所需图形在晶圆表面上定位或对准,而曝光的目的是要是通过汞弧灯或其他辐射源将图形转移到光刻胶图层上。
用尽可能短的时间使光刻胶充分感光,在显影后获得尽可能高的留膜率,近似垂直的光刻胶侧壁和可控的线宽。
5
PEB
在曝光时由于驻波效应的存在,光刻胶侧壁会有不平整的现象,曝光后进行烘烤,可使感光与未感光边界处的高分子化合物重新分布,最后达到平衡,基本可以消除驻波效应。

6
显影
显影就是用显影液溶解掉不需要的光刻胶,将掩膜版上的图形转移到光刻胶上。
7
硬烘烤
目的是通过溶液的蒸发来固化光刻胶,此处理提高了光刻胶对衬底的粘附性,为下一步工艺做好准备,如提高光刻胶的抗刻蚀能力。
8
检验
显影检查是为了查找光刻胶中成形图形的缺陷。继续进行刻蚀工艺或离子注入工艺前必须进行检查以鉴别并除去有缺陷的晶圆。
附:
技术资料